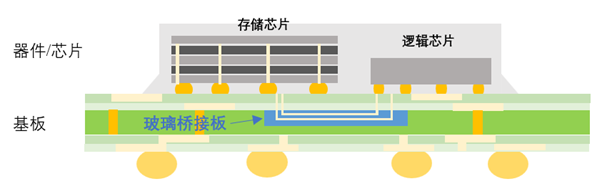
玻璃基材的广阔未来
上一篇提到了无源集成器件作为玻璃基材的一大应用,目前已在各种模组被广泛采用。玻璃 – 无源互连集成的下一代基材(一)
玻璃的应用不仅于此,除了集成无源器件IPD,还有很多集成电路和先进封装领域正采用玻璃技术。基于其优良的电和机械性能,玻璃在各种集成电路无源互连有广泛应用前景。随着玻璃转接板和玻璃基板的量产落地,集成电路中除半导体器件以外的无源互连类应用,正催生玻璃技术蓬勃发展,完善壮大基于玻璃基底的材料/设备/工艺/应用的完整产业链,成为集成电路领域的新的重要增长点。
高密度转接
大规模智能系统的快速发展,大量增加了对高密度高带宽互连的需求。转接板(interposer)是实现此类高性能高密度互连的核心,需要匹配超大数量引脚和精细走线,同时还需要具有低损耗,低信号失真等优良电性能。
硅转接板(silicon interposer)是此类应用的优秀解决方案。其中的核心技术是TSV(Through Silicon Via)。采用CMOS工艺中的高密度互连工艺,再加上TSV的高密度通孔能力,硅转接板可以满足高密度互连的需求。
而玻璃转接板,则可以实现对硅转接板的性能升级,是此类应用的更优秀解决方案。相比硅转接板,玻璃转接板可以在更简单和低成本的条件下,却实现更好的性能。
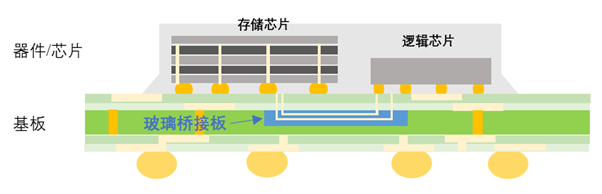
玻璃桥接板应用
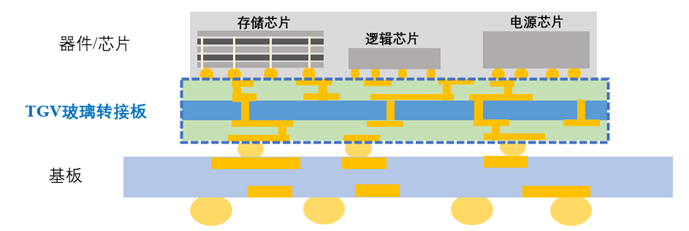
TGV玻璃转接板应用
它的主要优势包括:
1. 高互连密度:高平整度的玻璃基底和TGV(Through Glass Via)工艺可以保证高密度金属互连工艺实现。可以实现高密度I/O大芯片间的互连。
2. 信号完整性:由于TGV技术的低介电常数和低传输损耗,尤其是在高频率下。使得它能够保证在转接板上互连的高速高带宽信号完整性。

更低RC延迟和损耗,适合高速传输应用
3. 机械可靠性:玻璃材料具有可调节的热膨胀系数,有助于减少由于热膨胀系数不匹配导致的封装失效,尤其在大尺寸芯片互连条件下。玻璃材料的高气密性和良好的机械稳定性,也使得玻璃转接板封装具有更高可靠性。
4. 成本效益:相比传统基板等连接板,高密度转接板本身明显成本较高。玻璃转接板技术有助于降低整体成本。玻璃基底相比高阻硅成本更低。TGV工艺相比TSV工艺也具有大幅度的成本优势。相比硅转接板,玻璃不需要帮助绝缘的额外工艺也可降低成本。
玻璃封装基板
相比于转接板主要用于封装内大芯片的2.5D互连,基板则是用于整体对外引脚的连接。随着高算力高带宽的需求推动,基板显然也需要向更高密度,更大尺寸,更高性能方向发展。尤其是人工智能和高性能运算等应用场景的庞大需求,推动芯粒(Chiplet)和先进封装等相关技术的快速发展。而更多芯粒间的互连,更大规模的芯片,都大幅提高了对高性能大规模互连的要求。而目前基板的密度和大尺寸可靠性都无法满足此类应用的需求。
传统的高密度基板一般使用层压工艺和build-up film方案来实现多层互联作用,在先进封装中,由于对互连线密度要求更高,以ABF(Ajinomoto build-up film )基板为主,其构成中主要包括ABF膜、BT芯板、铜走线等,如下图所示(图片来自Ajinomoto官网)。目前此方案面临的主要挑战,一方面是build-up film层中的连线虽已可达到较高密度,但仍受限于膜层表面粗糙度和布线粘附性的限制,挑战更高密度的难度很大。而另一方面是BT芯板的通孔连线密度较低,由于BT芯板加工工艺以及厚度的折衷选择,垂直互联密度较差,而且传统的有机芯板由于翘曲等问题也难以降低厚度以及扩大尺寸。总体而言,传统BT芯ABF基板难以满足更大规模更高密度的逻辑芯片封装需求。这也是英特尔等厂家宣布玻璃基板量产计划的主要原因。
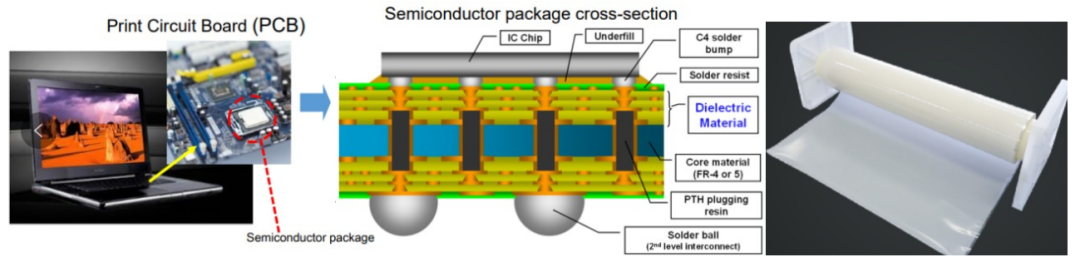
ABF基板叠层, ABF膜

BT芯板 build-up film 基板
玻璃芯板是可以很好解决上述问题的优选方案,既可以大幅度提升垂直互联密度,又得益于其优异的平坦度、热和机械稳定性等方面优势使得玻璃芯板可以实现更薄更高密度更可靠的IC基板。通过TGV技术,玻璃芯板可以实现更加密集的垂直互联通孔。玻璃芯板上的build-up film层可以选择基板工艺中的dry film方式,也可以选择采用有机介质膜等,以实现高密度布线,结构通常如下图所示。

玻璃芯板 build-up film 基板
包括英特尔在内的大芯片厂家纷纷涉足玻璃基板开发,并宣布玻璃基板的量产计划。高密度高性能大尺寸互连基板正朝玻璃基板方向演进。
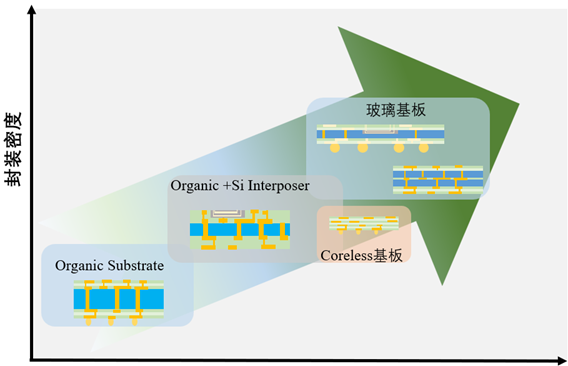
向玻璃基板方向发展
玻璃基板可以满足更高密度、更高性能的芯片封装需求,可显著改善电气和机械性能,可调模量和CTE,以更匹配硅基芯片,从而支持面板级的大尺寸加工工艺,提供更优良的性能以及更高的产业效率。
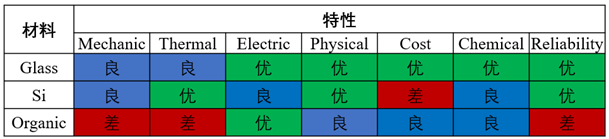
玻璃具有整体更适合大尺寸封装基板应用的特性
面板级加工工艺在不断增大的整体封装尺寸下,尤其重要。一方面晶圆圆形面积的利用率随着单基板尺寸的增加而大幅降低,另一方面,单晶圆的基板数量也较低,难以获得高产能和成本效益。而板级玻璃加工则可以解决此问题。获得50%以上的面积利用率提升和数倍的单片加工效率。
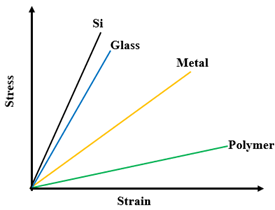
玻璃具有优秀的抗形变能力

板级玻璃基板成本效益明显,尤其是在大尺寸封装条件下
TGV微机电封装
MEMS封装技术是微电子封装领域的一个重要分支,它涉及到将微机电系统(MEMS)的微型化、集成化器件进行封装以确保其性能和可靠性。由于玻璃具有良好的机械和环境隔绝能力,是适合进行MEMS封装的材料选择,结合其优秀电性能及TGV玻璃通孔工艺,可以实现灵活可靠且高性能的微机电系统封装。MEMS封装中的一大应用场景是射频滤波器的封装。通过玻璃通孔或成槽工艺,可以实现各种机械波器件,如声表SAW器件,体声波BAW器件工作所需要的空腔结构。
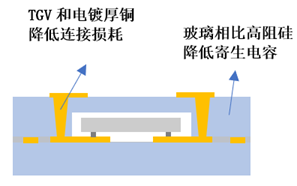
玻璃空腔的电性能优势
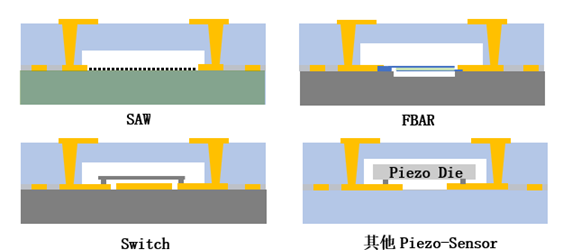
玻璃空腔的MEMS应用
玻璃腔盖相比于干膜等有机材料成腔的气密性更好,机械强度更高,电性能影响更小。玻璃腔盖相比于硅盖,则具有玻璃转接板相比于硅转接板的类似优势,如更佳的高频电性能,更低的成本等。随着集成电路领域玻璃产业链的发展,基于玻璃各方面优势的MEMS器件玻璃封装也将获得更广泛的应用和发展。
同时由于玻璃具有优秀的射频性能和可集成无源器件的工艺能力,在射频模组封装领域有进一步提高集成度和性能的解决方案。通过集成电感电容等IPD器件,滤波器的额外匹配及芯片间的互连,通过玻璃基底可实现更高集成度和更高性能的射频前端模组。
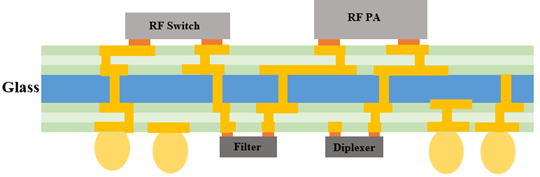
射频前端模组的玻璃封装
森丸电子TGV方案
森丸电子作为国内较早实现TGV通孔制备到实现产品化完整半导体工艺能力的团队,建立了兼有玻璃晶圆和玻璃面板TGV工艺能力的加工平台。森丸电子拥有深槽刻蚀,晶圆键合,各种厚薄膜工艺及深孔金属化的能力。在这些专业能力基础上的灵活应用,可为客户提供有针对性的新产品开发和生产流程方案。
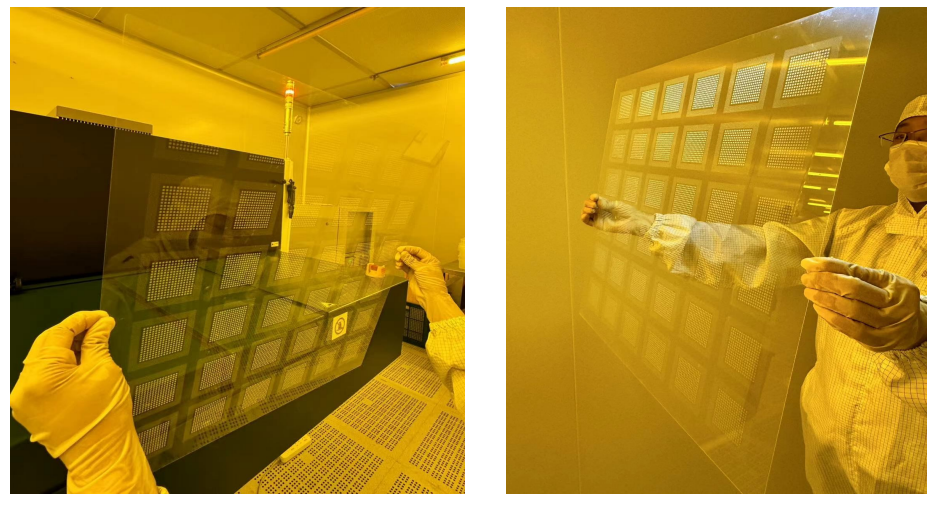
森丸面板级TGV
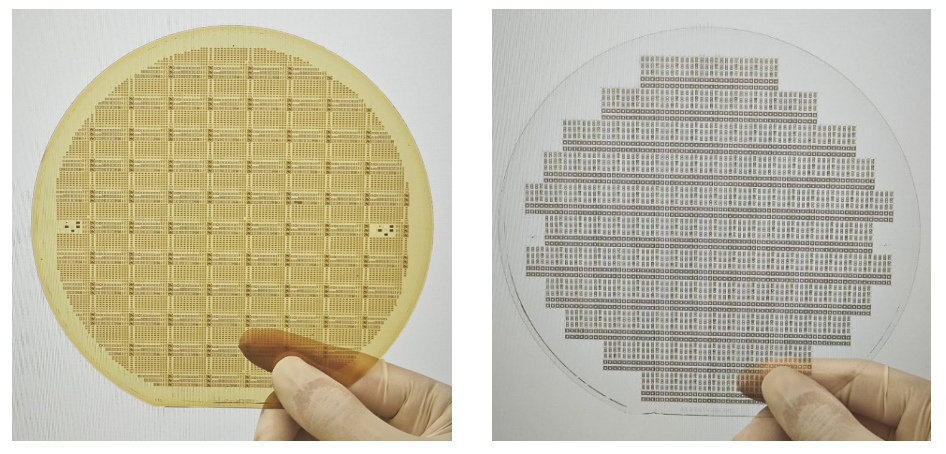
森丸晶圆级TGV
关于elexcon2024深圳国际电子展
elexcon2024深圳国际电子展将于2024年8月27-29日在深圳会展中心(福田)举办。汇聚400+家全球优质品牌广商齐聚现场,打造电子全产业链创新展示、一站式采购及技术交流平台。集中展示集成电路、嵌入式系统、电源管理/功率器件、电子元件与供应链、OSAT封装服务、Chiplet异构集成产业链专区、3D IC设计/EDA工具、IC载板/玻璃基板、先进材料、半导体制造专用设备等热门产品;展会期间还将举办一系列技术论坛,展示全球产业动态及未来技术趋势。参展/演讲/赞助请联系:0755-8831 1535,更多展会详情请登录:www.elexcon.com。