
来源:全球半导体观察
8月27-29日,由博闻创意会展(深圳)有限公司主办的elexcon2024深圳国际电子展在深圳会展中心(福田)盛大开幕。本次展会聚集了400+全球供应商厂商,展示嵌入式AI、存储技术、汽车芯片元件、智能传感器、RISC-V、chiplet、SiC/GaN、TGV玻璃基板等一系列热门技术与生态,并举办了20多场专业论坛会议,涵盖了AI PC、智能传感器、新能源汽车电子、化合物半导体、数字电源、FPGA生态、工业AI数智化、电子元器件供应链发展趋势、系统级封装SiP等多个主题。众多行业专家/人士,以及企业高管齐聚elexcon2024,揭开AI浪潮下众多热门技术最新进展,共同探讨市场趋势以及未来前景。

AI人工智能的爆火,为存储器产业带来了新一轮的发展机遇。就两大存储器产品而言,DRAM领域,AI加速芯片带动HBM需求日益增长,同时,CXL内存技术因其特性也备受关注;在NAND Flash领域,近期具备速度、低延迟、耐用性和节能等优势的SSD,热度持续上升。业界认为,随着更多生成信息是以影片或相片显示,数据存储量也相应增加,故TLC/QLC(四层单元闪存) 16TB以上等大容量SSD便成为AI推理主要采用的产品。
值得一提的是,最近一款国民现象级游戏“黑神话·悟空”爆火,该款游戏背后涉及到的虚拟现实、人工智能等多项前沿技术,离不开芯片底层技术的支持,而存储器正是其助力之一。
在本次elexcon2024 展会上,存储厂商备受瞩目,包括时创意、康盈半导体、铨兴科技、康芯威、紫光国芯、海康存储、长江万润半导体、喻芯半导体、金泰克、德明利等厂商纷纷“大显身手”,展示了内存新技术进展以及SSD等产品,覆盖消费电子、车规级、AI高性能场景等领域。
·铨兴科技
铨兴科技此次向外展示了最新研发的AI训推一体机LLM本地化部署解决方案以及一系列中高端存储产品。
铨兴科技展示的高端存储产品,涵盖消费级、工规级、车规级、企业级在内。企业级产品包括U.2 PCle 5.0 QLC SSD、ES33H01 U.3 NVMe SSD、DRR4 R-DIMM。其中,ES33H01 U.3 NVMe SSD产品,支持业界最新U.3接口 ,可完全向后兼容U.2插槽,采用PCle Gen 4和NVMe 1.4,最高可实现7400/6900 MB/s的顺序读写和1750K/480K IOPS的随机读写,为数据中心应用提供高性能、低延迟、高可靠。

图片来源:全球半导体观察摄
AI产品方面,铨兴AI训推一体机主要由铨兴添翼AI扩容卡、企业级固态硬盘、服务器内存等核心组件组成,包括铨兴添翼AI扩容卡、DDR5 R-DIMM、SATA/NVMe eSSD等。此方案可显著降低大模型训练的门槛,实现70B-180B 超大模型、高精度、全参微调,对Llama、Mistral、千问、智普等主流开源大模型实现了完美支持,成本不到100万元,节省超85%,大幅降低大模型的微调成本。
铨兴科技透露,目前已经与多家国产CPU、国产GPU、软件服务商、AI服务器整机厂商、厦门大学等高校以及政府部门建立了合作关系,共同推动AI技术的发展和应用。

图片来源:全球半导体观察摄
资料显示,深圳市铨兴科技有限公司是集研发、生产、销售为一体的半导体存储产品解决方案商,涵盖 DRAM 和 NAND Flash 两大领域,公司旗下拥有铨天智能制造生产基地、香港国际供应链平台。此外,针对封测方面,铨兴科技具备BGA、LGA、SiP 等先进封装技术,并掌握多项封装设计仿真技术,自研测试软件开发、测试算法,拥有多条高配的模组制造产线。
·康盈半导体
康盈半导体在此次展会以“向芯而行,智储无界”为主题,发布2024自研存储新产品,3大自研新品分别是,星河之芯小精灵——自研主控eMMC嵌入式存储芯片、速影之芯小木星——自研主控microSD移动存储卡、随存之芯小金刚PSSD——便携式磁吸移动固态硬盘。

星河之芯小精灵eMMC,采用自主研发的eMMC主控芯片,兼容各主流平台,多容量选择,4GB至256GB,支持更多场景应用;速影之芯小木星microSD,采用自主研发的主控解决方案,支持DDR200模式,极速读写,搭载先进的S.M.A.R.T.功能,容量包含32GB-1TB多种选择;随存之芯小金刚 PSSD,最高读取速度高达2000MB/s,最高写入速度高达1800MB/s,具有磁性吸附功能,支持ProRes视频录制,实现随拍随存。
据悉,目前,康盈半导体在嵌入式存储产品线工业级和消费级产品阵营日趋壮大,现已广泛应用于智能终端、智能穿戴、智能家居、物联网、网络通信、工控设备、车载电子、智慧安防、智慧医疗等领域。

·时创意
本次时创意展示了以UFS 3.1、LPDDR5、eMMC5.1、ePOP为代表的高性能嵌入式存储芯片及应用案例。
其中,时创意的UFS3.1针对AI及旗舰智能手机,时创意全面量产512GB UFS3.1 高性能嵌入式闪存芯片,顺序读写速度分别高达2100MB/s、1700MB/s,理论带宽达2.9GB/s,尺寸仅为11.5×13.0×1.0mm,具有高速率、稳定兼容、耐用可靠等特点;LPDDR5传输速率6400Mbps,带宽高达51GB/s,工作电压低至0.5V,相较LPDDR4/4X整体性能提升50%、功耗降低达30%,兼备高性能与低功耗优势;eMMC5.1基于时创意自研固件算法,顺序读取、写入速度分别高达320MB/s、200MB/s,256GB大容量存储,具有体积小、高集成度、高可靠性等特点。
据悉,时创意还带来了新产品SSP24 Pro移动固态硬盘,该产品基于3D TLC NAND颗粒,支持USB 3.2 Gen2x2高速传输标准,顺序读写速度高达2000MB/S、1800MB/S、3.5倍于普通固态移动硬盘的传输速度,可以满足高速存储和大型文件传输等任务,极大节省加载时间。该产品重量70g,支持Windows/Mac OS/OS/Linux等主流系统,采用可正反盲插的Type一C接口,随配双Type-C数据线,可连接手机、iPad Pro、电脑、游戏机、相机等。

图片来源:全球半导体观察摄
值得一提的是,最近火热的《黑神话·悟空》游戏中,时创意指出,公司为电竞玩家打造高效可靠的存储解决方案,包括DDR5 UDIMM RGB电竞游戏版超高频内存条,采用Hynix A-Die颗粒,频率高达8000MHz,双条容量可达32GB(16GBx2),充足的内存空间避免酣战时出现卡顿、掉线等问题;S7000、S7000 Pro和C7000系列SSD固态硬盘,均采用PCIe 4.0 x4高速接口,优势在于优越的性能速度,可以减少延迟,并具备多种容量选择。

·紫光国芯
紫光国芯在elexcon2024深圳国际电子展上,带来了多款前沿产品和创新方案,面向汽车电子、人工智能、高性能计算、工业控制、物联网和消费电子等多个关键领域。

具体来看,紫光国芯的新一代车规级低功耗动态随机存储器LPDDR4/LPDDR4X等多款具有自主知识产权的高可靠车规级芯片产品和解决方案,可应用于激光雷达、车联网终端、抬头显示、液晶仪表、车辆动态控制系统、行车记录仪、驾驶员监测系统等汽车电子控制系统领域。此次,紫光国芯带来的LPDDR4 DRAM(第四代低功耗同步动态随机存取存储器),主要为满足智能网联化对车载电子系统的性能和可靠性要求而设计。目前,该产品已通过研发验证及AEC-Q100可靠性认证,处于量产阶段。
存储SSD产品方面,此次展会上,紫光国芯展出了面向行业应用开发的高端SSD产品「CTD700」、「BTD300」和「ATK110」,以及面向消费市场的国潮SSD产品「T5-新纪」。模组产品方面,紫光国芯展出了RDIMM和U/SO-DIMM等产品,公司全系列模组产品广泛应用于高性能计算、PC等主流市场以及网络通信、工业控制等利基市场。据悉,紫光国芯开发的新一代DDR5 RDIMM在容量、功耗、总线效率等方面有显著提升,速率可达5600Mbps,满足了企业级应用在性能和质量方面的更高要求,可为国产CPU平台以及英特尔第5代至强可扩展处理器Emerald Rapids等平台提供内存解决方案。
值得一提的是,紫光国芯“在芯片级用嵌入式DRAM(SeDRAM®)技术实现大带宽、大容量嵌入式存储”和“在系统级用CXL技术实现内存容量、带宽扩展”的方案。其中,SeDRAM®技术已演进至第三代,其针对人工智能大模型和高性能计算HPC等领域的应用,实现了数十TB的内存访问带宽和数十GB的存储容量。
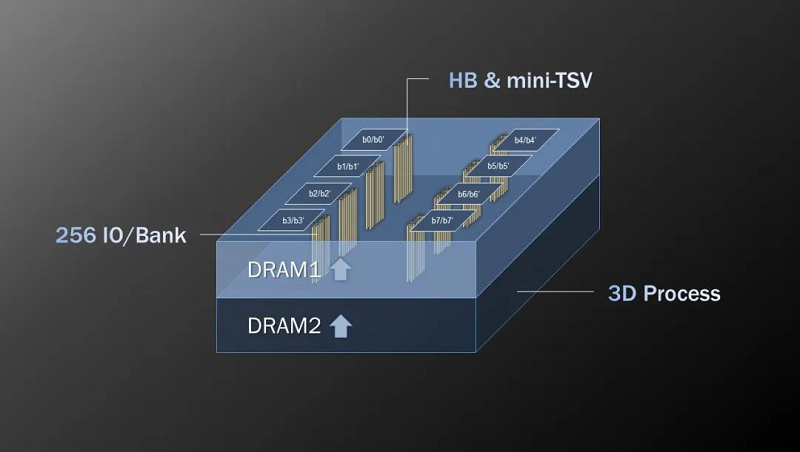
嵌入式多层阵列SeDRAM®示意图(图片来源:紫光国芯)
去年,西安紫光国芯在VLSI 2023发布了新一代多层阵列SeDRAM。据当时介绍,相较于上一代单层阵列结构,新一代技术平台主要采用了低温混合键合技术(Hybrid Bonding,HB)和mini-TSV堆积技术,每Gbit由2048个数据接口组成,每个接口数据速度达541 Mbps,最终实现135 GBps/Gbit带宽和0.66 pJ/bit能效,为叠加更多层DRAM阵列结构提供先进有效的解决方案。
·德明利
此次德明利展示了嵌入式存储系列、固态硬盘存储系列、内存条存储系列、移动存储系列,包括PCIE GEN5、LPDDR5/4X、LPCAMM2等新品在内。
其中,德明利M.2 2280 PCle Gen5.0x4 NVMe SSD,采用PCIe 5.0接口,具备8通道主控和外置DRAM,可实现接近15GB/s的极速读取。另外,NVMe 2.0协议的引入,以及SLC缓存技术的应用,确保设备处理高分辨率图形和复杂场景时,增强玩家的沉浸式体验,同时保持设备的便携性和电池续航。
LPCAMM2专为高性能计算、AI处理、超薄笔记本和移动设备设计,数据传输速率可达到7500Mbps,运行功耗降低58%,待机功耗降低80%,通过模块化设计减少60%空间。
LPDDR5/LPDDR4X嵌入式存储,速率可达6400Mbps,稳定传输速度可达4266Mbps,容量2GB-8GB。

图片来源:全球半导体观察摄
·海康存储
海康存储带来了旗下的消费级和行业级存储产品,以嵌入式产品线为核心,展示的产品主要面向服务器、车载应用、工业控制、消费电子等领域。
目前,海康存储嵌入式存储已经覆盖eMMC、LPDDR、DDR4、SPI NAND、Parallel NAND等产品系列,满足电力、网通、交通、移动终端、智能家居等细分市场的需求。
车载存储方面,海康存储车规级eMMC支持eMMC 5.1数据传输模式,具有高可靠性、高PE、高性能的特点,能确保在-40℃~105℃的极端环境下稳定运行,同时提供40GB/80GB/128GB多种容量选择;车载专用固态硬盘CZS01系列采用高品质3D NAND Flash颗粒和自主研发的固件,确保视频数据写入流畅稳定,-25°C~85°C的工作温度范围可轻松应对四季用车场景;车规级固态USB闪存盘HD200采用一体封装技术,符合车规Grade3温度标准,支持OTA在线升级以及项目深度定制,已实现量产出货,并与多家国内一线新能源汽车品牌达成合作。
据悉,海康存储本年度向中国移动批量交付的数据中心级固态硬盘D300系列、专为工控场景打造的V310系列以及年度重磅四盘位Nas新品R1等产品均有展出。
·康芯威
康芯威全面展示自主研发的嵌入式存储芯片,包括eMMC5.1产品。该产品支持目前规范高的HS400标准,在固件中加入断电保护、坏块监测等算法,大大提高了产品可靠性,采用更为先进的LDPC纠错算法,容错率相较传统算法提升三倍以上,可全方位覆盖4~256GB容量的产品以及2D/3D闪存。
康芯威销售副总苏俊杰表示,随着AI手机、AIPC、AI服务器需求迅速增长,以及智能电视、机顶盒等市场逐渐复苏,存储芯片需求将会增加。康芯威聚焦于嵌入式存储领域,正逐渐实现全领域布局。其中,eMMC存储器在消费电子、工控、车载等领域实现量产,产品进入中兴、九联、海信、康佳、星网锐捷、浪潮、保隆汽车等品牌供应链,累计销量超过5000万颗(数据截止至2024年7月)。

图片来源:全球半导体观察摄
·长江万润半导体
长江万润半导体带来了SSD、PSSD、eMMC、DDR、LPDDR等产品,包括2100MB/s读速的PSSD移动固态硬盘,高集成度小体积封装BGA SSD和高性能嵌入式eMMC,以及5600MHz高频UDIMM、SODIMM系列产品。
其中,长江万润半导体PCIe Gen4×4 SSD固态硬盘MC7000,采用的是原厂自封GOOD Die颗粒和行业主流存储控制器。MC7000 SSD随机性能(IOPS)1088K,闪存接口速率超过2400MB/s,读速度高达7400MB/s,不仅可以加快数据传输速率、减少延迟,从而实现更高的性能、更快的数据访问和增强的数据可靠性,可以满足AI和大语言模型、云端的服务器等场景。
据了解,长江万润半导体的UDIMM、SODIMM系列产品,采用原厂颗粒,有多种频率和容量可选,兼容市面主流操作系统,为游戏发烧友和电竞玩家提供高效、可靠的内存运行支撑,缩短加载时间,同时确保游戏画面和并行计算任务的流畅执行,可显著提升电脑性能和运行效率。

·朗科科技
此次展会,朗科科技展示了SSD、DDR内存、移动固态硬盘、闪存盘、存储卡等多个品类产品,覆盖日常办公、娱乐游戏、差旅出行等众多应用场景。其中,绝影NV7000、绝影RGB内存、 Z2S移动固态硬盘等明星产品备受关注。
朗科科技的NV7000绝影系列固态硬盘,容量是2TB,采用M.2 2280规格,使用M.2 Socket 3接口,传输模式PCIe 4.0x4,支持NVMe协议。由于自带散热马甲的关系,整体厚度达到了11.25mm。
而Z2S移动固态硬盘具备近乎5倍移动硬盘的传输速度,1G电影文件,大概2-3秒就能传输完毕,极大提升工作娱乐效率。支持电脑手机多设备直连,玻璃镜面机身,轻便易携。

图片来源:全球半导体观察摄
·金泰克
金泰克在展会上展示了其渠道全系列存储产品,包括DDR内存和SSD固态硬盘两大类,覆盖消费类、工控级及针对中小型企业的KT-B900系列。
消费类存储产品,从前瞻性的产品如"战虎G5"内存,频率高达8000MHz,以及"战虎G7000"固态硬盘,读速高达7000MB/s,为大型3A游戏和专业创作提供流畅体验,到性价比极高的"速虎武曲星"和"速虎白月光"内存,均能满足不同用户的需求。
工控级产品,包括DDR5、DDR4、DDR3内存和PCIE3.0、PCIE4.0,以稳定性和可靠性著称,适应严苛工业环境,广受市场好评。
KT-B900系列,专为中小型企业设计,提供高效稳定的数据存储解决方案,优化数据处理流程,提升工作效率。

图片来源:全球半导体观察摄
·喻芯半导体
喻芯半导体展出了多款存储产品,包括高性能的基于长存最新3D NAND的嵌入式存储eMMC、SPI NAND、内存颗粒DDR3L/DDR4/LPDDR4x、闪存颗粒Raw NAND、高速闪存卡micro SD,消费级和企业级SATA/mSATA/M.2 SSD、PCIe3.0/4.0 SSD等以及各种存储解决方案。
喻芯半导体指出,使用搭载了喻芯最新F800系列SSD产品(PCIe4.0 X4)的PC电脑进行现场跑分实测,并与观众进行了最新款3A大制作游戏《黑神话·悟空》火热互动和体验,游戏画面流畅、性能优异、SSD读写速度超过7000MB/s,跑分系统实测喻芯F800系列SSD的性能行业领先。

图片来源:全球半导体观察摄
喻芯半导体专注于存储芯片设计研发、模组设计、测试与销售等服务,提供高性能的存储芯片设计、完整的DRAM和NAND Flash相关存储产品,包括SPI NAND、PPI NAND、Raw NAND、嵌入式存储 (eMMC/DRAM颗粒)、DRAM Module、SSD、microSD等存储解决方案。

图片来源:全球半导体观察摄
早先的SiP、PoP技术奠定了先进封装技术基础,而后出现的包括2D集成技术如倒装类(flipChip,Bumping),晶圆级封装(WLCSP,FOWLP,PLP),2.5D封装(Interposer)及3D封装(ThroughsiiconVia(硅通孔,TSV))等更是加速推进先进封装发展的脚步。随着先进封装技术更迭,进一步缩小芯片间的连接距离,提高元器件反应速度,带来了更高封装效率、更低成本及更好性能的效果,正是业界所需。
当前后摩尔时代下,人工智能(AI)、5G/6G、新能源汽车、物联网等新兴应用推动半导体产业发展。而AI芯片对算力、高性能的需求持续增加,要达到算力提升、带宽扩增和功耗降低的效果需要依赖创新的先进封装技术,其中2.5D/3D封装、面板级封装、混合键合、玻璃基板等技术成为了业界优先考虑的解决方案。业界认为,先进封装增速将高于整体封装,会成为下一阶段半导体技术的重要发展方向。
华天科技TPM经理朱浩在8月28日举行的分论坛三--异构系统集成实现(生态圈)会议上,发表了《先进封装驱动智能世界发展》的主题演讲,指出当前的热点市场包括汽车网联化,电动化,智能化带动汽车电子市场规模持续增大;Vision Pro为智能穿戴市场带来新的生机;生成式AI高速发展;Mate 60卫星通讯受追捧;第三代半导体市场潜力巨大;智能机器人技术快迪发展;24年脑机技术或将进入应用;存储市场逐渐回温;智能家居渗透率逐步上升。对于封装市场而言,虽然传统SiP封装仍保有一定的市场份额,但大颗FCBGA已逐渐成为行业的主导。随着对多芯片集成和高密度互连技术需求的增加,市场对具备高散热、低功耗的封装方案提出了更高的要求。在此背景下,2.5D和3D封装技术显示出巨大的发展潜力,并预计在未来将实现快速增长。
此外,全球先进封装市场玩家主要包括IDM(半导体垂直整合制造商)、Foundry(晶圆代工厂)以及OSAT(委外封测服务)供应商等,目前,日月光、安靠、长电科技、台积电、三星及英特尔,6家大厂合计占据了整个先进封装市场近80%的市场份额。
先进封装越来越火热,从本次elexcon2024深圳国际电子展来看,不少先进封装厂商纷纷现身展会,展示其重要技术产品,涉及华润微、锐杰微、通富微电、联合微电子、云天科技等。
·华润微
华润微是一家IDM半导体企业,拥有四大事业群,分别是集成电路事业群、功率器件事业群、代工事业群、封测事业群。其中,封测事业群(Assembly&Test Business Group,以下简称“ATBG”)是华润微电子旗下半导体封装测试代工平台。

资料显示,ATBG主要为国内外无芯片制造工厂的半导体公司提供各种封装测试代工业务,其产品广泛应用于消费电子、家电,通信电子、工业控制、汽车电子等领域。主要业务种类有半导体晶圆测试(CP),传统IC封装,功率器件封装(FLIPCHIP工艺),大功率模块封装(IPM), 先进面板封装(PLP),硅麦、光耦传感器封装, 成品测试等TURNKEY业务,并在无锡,深圳,东莞,重庆建立了生产基地。
从产业链和布局基地来看,华润微覆盖全产业链tumnkey服务封装,晶圆测试环节主要是深圳赛美科,封装环节是无锡安盛、重庆矽磐、深圳赛美科、东莞杰群,成品测试是深圳赛美科、无锡安盛。
其中,无锡安盛具备高可靠性传统IC封装,拥有TSSOP、SSOP、SOT、MSOP、SOP、QFN、FCOL package等多个系列百余个品种的封装形式;重庆矽磐则定位先进面板封装,引进国际先进面板封装工艺,提供高能效低成本封装方案,用于功率产品大规模封装,可替代传统QFN,LGABGA等;东莞杰群聚焦功率电子封测业务,包括Stacks、Modules. Mos-FETS /IGBTS.Drivers、IPMs.Controllers。
从封装工艺上看,华润微主要分为了IPM封装、Copper Clip封装、覆晶工艺、面板封装、器件封装。其中,Copper Clip工艺封装,应用于功率器件封装,以及应用铜块连接MOS FET的Source与框架(leadframe)以获得更好的Rdson以及更好的热效应。该技术基于通孔和凸台的建设,通孔可以帮助模流,减少应力,增加结合力,在关键区域的通孔会影响导通电阻。凸台设计防止 solder overflow,造成漏极与源极短路,有利于树脂填充,实现方法分为腐蚀和冲压两种制程。

图片来源:华润微
·锐杰微
苏州锐杰微科技集团有限公司(以下简称“锐杰微科技”,RMT)是一家聚焦Chiplet&高端芯片的OSAT企业,覆盖复杂芯片封装设计&仿真、规模化加工制造及成品测试流程。公司已建立一套完整的封装设计标准、生产管控流程,质量保证体系,配备先进规模化的封测产线,目前在上海、苏州、成都、长沙等地建设有办事处和基地。

锐杰微科技董事长方家恩于8月28日在第八届中国系统级封装大会上发表了《Chiplet芯片技术在封装级的相关应用》的主题演讲,指出高性能芯片广泛采用Chiplet技术已经成为趋势,成为推动算力发展的主流技术,并围绕封装技术路线、芯粒互联的封装设计和组装工艺平台的重要节点,阐述了其在封装级的应用实践。
锐杰微的产品方向主要是FCBGA/Chiplet封装测试。在CoW工艺领域,锐杰微已成功制备出包含1.5倍光罩尺寸的硅中介板,die bump间距为40um,bump数量高达20000个的集成组件。
目前,锐杰微在郑州、苏州两地设有工厂,现已具备Chiplet设计全流程及工艺全流程的能力。2024年,郑州基地通过IATF 16949 认证,该基地是综合类封装测试基地和国产车规封测基地,具备Bumping、TSV、硅载板加工;同年,苏州基地获得QEHS认证,同时苏州先进封测基地已全面量产,产能3000万颗/年,可建设12条FCBGA+Chiplet+CP/FT/SLT封测线。该公司计划苏州基地预计2025年获得IATF 16949 认证。
·通富微电
通富微电是集成电路封装测试服务提供商,是中国集成电路封装测试的企业,总部位于江苏南通,拥有全球化的制造和服务基地,在南通、合肥、厦门、苏州、马来西亚槟城拥有七大生产基地。


图片来源:全球半导体观察摄
通富微电产品技术拥有FCBGA系列、FCCSP系列、FO系列、HVP系列、LQFP系列、QFNDFN系列、SiP系列、WBBGALGA(HS)PBGAB系列、WLP系列。
在先进封装市场方面,通富微电此前表示,公司持续发力服务器和客户端市场大尺寸高算力产品。此外,通富微电先进封装项目于今年5月份签约落户苏锡通科技产业园区。
通富微电针对大尺寸多芯片Chiplet封装特点,新开发了Cornerfill、CPB等工艺,增强对chip的保护,进一步提升芯片可靠性。基于玻璃芯基板和玻璃转接板的FCBGA芯片封装技术,不断开发面向光电通信、消费电子、人工智能等领域对高性能芯片的需求。16层芯片堆叠封装产品大批量出货,合格率居业内领先水平;国内首家WB分腔屏蔽技术、Plasma dicing技术进入量产阶段。
·云天科技
本次云天半导体展示了2.5D高密度TGV(Through Glass Via)转接板样品、高深宽比75:1的TGV样品、SAW-WLP、IPD、Fanout等晶圆样品。
资料显示,云天半导体成立于2018年7月,致力于面向新兴半导体产业的先进封装与系统集成,通过自主研发与持续创新,为客户提出从产品协同设计、工艺研发到批量生产的全流程解决方案和服务。主营业务包括晶圆级三维封装(WLP)、晶圆级扇出型封装(FO)、系统级封装(SiP)及模块(Module)、IPD无源器件制造、高密度2.5D转接板(基于TGV技术)和高精度天线制造等,已经为国内外百余家客户提供了设计、封装、集成服务。该公司突破了一系列核心关键技术,具备从4寸、6寸、8寸到12寸全系列晶圆级系统封装和精密制造能力。
云天半导体产品系列包括云天-WLP/CSP、云天-eGFO/eMFO、云天-Bumping、云天-WL IPD、云天-TGV、云天-化镀、云天-2.5D TGV Interpose、云天-DPS。产品进度方面,近日,云天半导体向外披露了其先进封装技术——晶圆级封装(Through Glass Via, TGV)出货量已突破2万片大关。TGV技术作为一种新兴的封装技术,被广泛应用于3D集成电路封装、MEMS(微机电系统)、生物医疗、通信以及传感器等领域。


图片来源:全球半导体观察摄
此前2月份,云天半导体向外宣布突破2.5D高密度玻璃中介层技术,并实现了规模化量产,该技术未来将助力AI等应用的CPU、GPU产品的先进封装。2.5D中介层转接板被称为先进封装集成的关键技术。与硅基相比,玻璃基(TGV)具有优良的高频电学、力学性能、工艺流程简化和成本低等优势,并能实现光电合封,是理想的芯粒三维集成解决方案。
据介绍,该玻璃转接板面积为2700mm2(60mm×45mm),厚度为80μm,TGV开口直径25μm,实现8:1高深宽比的TGV盲孔无孔洞填充。金属布线采用无机薄膜介质材料,实现3层RDL堆叠,通过调试干法刻蚀参数、优化CMP抛光能力实现细间距RDL,其中最小L/S可达1.5/1.5μm。并通过多场reticle拼接技术可满足大尺寸转接板制备,其中拼接精度可控在100nm以内。电性测试结果表明基于玻璃基的无机RDL结构较有机RDL损耗降低10%。
·联合微电子
联合微电子中心(CUMEC)以硅基光电子、微系统先进封装、多光谱探测、碳基集成电路等工艺技术和产品技术为核心。公司已建成国内首个开放硅基光电子、微系统先进封装等工艺的光电集成高端特色工艺平台,已经对外发布7套工艺PDK,器件性能和工艺能力处于国内领先、国际先进水平。
据联合微电子中心相关负责人介绍,其PDK(CSIP180AL)基于180nm硅光工艺开发,衬底采用200mm SOI晶圆,220nm顶层硅+2μm BOX提供3层硅刻蚀,4 x P/N掺杂,Ge外延,热电极,金属互连等工艺,可选无源和有源规格。
联合微电子中心微系统中心副主任唐昭焕于8月27日举行的"分论坛二异构系统集成制造”中,发表题为《高算力芯粒集成硅基板及硅桥工艺技术平台》的主题演讲,并表示,Chiplet(芯粒)集成是后摩尔时代先进制程发展交缓背景下支持高算力芯片研发的新途径,是国内发展半导体产业的新赛道。发展芯粒集成需要传统Foundry与OSAT的高度协同,但高算力芯粒集成的技术瓶颈是互联。同时,他针对UCIE支持的四种芯粒集成架构,介绍了公司依托自主工艺8英寸90nm工艺线,研发的5*50/10*100/20*200硅转接板(ColoS)及硅桥(HDIB-H/L)工艺技术解决方案。

图片来源:全球半导体观察摄
关于elexcon2024深圳国际电子展
elexcon2024深圳国际电子展将于2024年8月27-29日在深圳会展中心(福田)举办。汇聚400+家全球优质品牌广商齐聚现场,打造电子全产业链创新展示、一站式采购及技术交流平台。集中展示集成电路、嵌入式系统、电源管理/功率器件、电子元件与供应链、OSAT封装服务、Chiplet异构集成产业链专区、3D IC设计/EDA工具、IC载板/玻璃基板、先进材料、半导体制造专用设备等热门产品;展会期间还将举办一系列技术论坛,展示全球产业动态及未来技术趋势。参展/演讲/赞助请联系:0755-8831 1535,更多展会详情请登录:www.elexcon.com 。